
支柱瓷絕緣子及瓷套的超聲波探傷方法
支柱瓷絕緣子及瓷套的超聲波探傷檢測主要采用下述三種方法,當用一種方法探傷時如發現缺陷,可選用另 一種方法驗證,也可用參考試塊作比對試驗,以提高檢測結果的準確性,探傷方法如下:
1)支柱瓷絕緣子及瓷套法蘭膠裝區表麵和近表麵缺陷的超聲波探傷采用爬波法;
2)支柱瓷絕緣子內部和對稱側表麵或近表麵缺陷的超聲波探傷采用小角度縱波斜入射法;
3)瓷套內部和內壁缺陷的超聲波探傷采用雙晶斜探頭橫波法。
一、爬波法
1. 探頭的選擇
1) 探頭的型式
使用並聯式結構爬波探頭。探頭頻率為 2.5MHZ,晶片尺寸選用 10mm×12mm 雙晶片,移動範圍較小時 采用 8mm×10mm 或 6mm×10mm 雙晶片探頭。在探頭移動範圍許可的情況下,宜選擇較大晶片探頭。
2) 探頭的弧麵 探頭移動時要求保持與檢測麵的良好吻合,應選用與試件曲麵相匹配的探頭。一般可在支柱瓷絕緣子及瓷套直徑變化 20mm 範圍內選用一種規格弧度的探頭,但僅允許曲率半徑大的探頭探測曲麵半徑小 一檔的試件(一檔為 20mm)。探頭的弧麵直徑分為:Φ100mm、Φ120mm、Φ140mm、Φ160mm、Φ180mm、 Φ200mm、Φ220mm、Φ240mm、Φ260mm、Φ280mm、Φ300mm、Φ400mm、Φ500mm、Φ600mm 以及平麵 15 種規格。
3) 探頭信噪比控製 探頭信噪比的控製水平見表 1。
| 表1 探頭信噪比控製水平 | |||||
| 探測距離,mm | 10 | 20 | 30 | 40 | 50 |
| 雜波高度,% | 0 | 0 | ≤2 | ≤5 | ≤6 |
|
注:1. 探測距離是指爬波探頭前沿距校準試塊上模擬裂紋的距離; 2. 雜波高度是指校準試塊上深度 5mm 的模擬裂紋 80%波高時的雜波高度。 |
|||||
2. 掃描時基線比例的調整
掃描時基線比例按聲程定位法調整,將時間軸(最大量程)調整為 60mm 即可。
3. 距離—波幅曲線(DAC 曲線)的繪製:
將探頭置於校準試塊上,探頭前沿距離深度5mm模擬裂紋10mm,測出最強反射波,調到80%屏高,然後依次測出距離分別為20mm、30mm、40mm、50mm處模擬裂紋波高,在示波屏上繪製出一條距離—波幅曲 線,見圖 1。

4. 掃查靈敏度調整
采用校準試塊調整掃查靈敏度。將探頭置於試塊上,找出距探頭前沿 10mm、深度為 5mm 模擬裂紋 的最強反射波,調整到 80%屏高,作為基準靈敏度。再根據實測的聲速確定掃查靈敏度,具體如下:
在基準靈敏度下,當聲速為 6700m/s 時,增益為 0,此時,基準靈敏度就是掃查靈敏度,而每當聲 速下降 100m/s 時,應在基準靈敏度基礎上提高增益 2 dB 作為掃查靈敏度。
上述檢測靈敏度即為支柱瓷絕緣子或瓷套外壁1mm深度模擬裂紋的等效靈敏度。
5. 缺陷的檢測
1) 按 3.5.3 進行掃查,對缺陷進行定量(最大反射波幅值及指示長度)和位置的測定。
2) 缺陷的定量測定 凡超過距離—波幅曲線高度的反射波均判定為缺陷波。缺陷最大反射波幅與距離—波幅曲線高度的差值,記為 DAC±( )dB。低於距離—波幅曲線高度的反射波采用半波高度法(6dB 法)測定其指示長 度。方法如下:
移動探頭,找到缺陷最強反射波,將波高調到80%屏高,向左(或向右)移動探頭,當波高降到40% 屏高時,在探頭中心線所對應的瓷體上作好標記,然後向右(或向左)移動探頭,同樣使波高降到40% 屏高並作好標記,兩標記間的距離即為缺陷的指示長度。
3) 缺陷的位置測定
根據探頭在探測麵上的位置和最高反射波在示波屏上的水平位置來確定缺陷的周向和軸向位置,並做好記錄。
二、小角度縱波法
1. 探頭的選擇
1) 探頭的型式 小角度縱波單晶斜探頭的選擇。在移動範圍許可的情況下,宜選擇較大角度折射角探頭,探頭的選
擇見表 2。
| 表2:推薦使用的探頭 | ||||
| 支柱瓷絕緣子規格,mm | Φ80~Φ120 | Φ120~Φ160 | Φ160~Φ200 | >Φ200 |
| 探頭晶片尺寸,mm×mm | 8×10 | 8×10 | 8×10 | 8×10 |
| 探頭頻率,MHZ | 5 | 5 | 5 | 2.5 |
| 探頭縱波折射角,βL | 18°~15° | 18°~12° | 15°~10° | 12°~8° |
2) 探頭的弧麵
選擇與被檢支柱瓷絕緣子曲麵相近的探頭
探頭移動時要求保持與檢測麵的良好吻合,應選用與試件曲麵相匹配的探頭。一般可在支柱瓷絕緣子及瓷套直徑變化 20mm 範圍內選用一種規格弧度的探頭,但僅允許曲率半徑大的探頭探測曲麵半徑小 一檔的試件(一檔為 20mm)。探頭的弧麵直徑分為:Φ100mm、Φ120mm、Φ140mm、Φ160mm、Φ180mm、 Φ200mm、Φ220mm、Φ240mm、Φ260mm、Φ280mm、Φ300mm、Φ400mm、Φ500mm、Φ600mm 以及平麵 15 種規格。
2. 掃描時基線比例的調整
掃描時基線比例按深度定位法調整。掃描比例依據直徑和選用的探頭角度來確定,最大檢測範圍應 至少達到時基線滿刻度的 60%。
3. 掃查靈敏度調整
采用校準試塊調整掃查靈敏度。將探頭置於試塊上,找出試塊上深 40mm、Φ1mm 橫通孔最強反射波, 調到 80%波高,此靈敏度相當於外徑 40mm 支柱瓷絕緣子的掃查靈敏度。支柱瓷絕緣子的外徑每增大 10mm, 掃查靈敏度提高增益 2dB,當支柱瓷絕緣子聲速小於 6100m/s 時,應在外徑差補償的基礎上再提高增益 2dB 至 4dB。
4. 缺陷的檢測
1) 掃查方式
a) 將探頭置於支柱瓷絕緣子或瓷套的傘裙與法蘭間,探頭前沿對準法蘭側,並保證探頭與檢測麵 的良好耦合。掃查速度不應超過 150mm/s(當采用自動報警裝置掃查時不受此限製),掃查覆蓋率應大 於探頭直徑的 10%。
b) 采用爬波法檢測時,探頭應盡可能向法蘭側前移,保持穩定接觸,作周向 360°掃查。
c) 采用縱波斜探頭或雙晶橫波探頭檢測時,在移動範圍許可的情況下,探頭可作前後移動,進行 周向 360°掃查。
d) 對缺陷進行定量(最大反射波幅值及指示長度)和位置的測定
2) 缺陷的定量測定
缺陷的定量測定方法如下:
a) 找到缺陷反射波的最大波高,根據 圖 1 調整掃查靈敏度的方法,與相近聲程Φ1mm 橫通孔進 行當量比較,判定為不小於Φ1mm 橫通孔當量或不大於Φ1mm 橫通孔當量,記錄為Φ1±( )dB;
b) 移動探頭,如缺陷波連續存在,采用半波高度法測定缺陷的指示長度;
c) 缺陷指示長度的修正
采用小角度縱波斜入射法檢測時,應對用半波高度法(6dB法)測出的缺陷指示長度進行修正,缺 陷指示長度值按下式計算:
L=(1-2H/D)L0
式中:L0—用半波高度法(6dB 法)測量時探頭位置之間的距離,mm;
’H—缺陷的深度,mm; D—絕緣子直徑,mm。
3) 根據探頭在探測麵上的位置和最高反射波在示波屏上的水平位置確定缺陷的周向位置和深度,並做好記錄。
三、雙晶斜探頭橫波法
1. 探頭的選擇
1) 探頭的型式
瓷套內部和內壁檢測采用雙晶橫波斜探頭。探頭頻率為 5MHZ,晶片尺寸選用 8mm×10mm 雙晶片, 橫 波折射角(βs)為 35°-37°。
2) 探頭的弧麵 探頭移動時要求保持與檢測麵的良好吻合。根據瓷套直徑、探頭弧麵直徑分為Φ160mm、Φ180mm、Φ200mm、Φ220mm 和平麵五種探頭。
2. 掃描時基線比例的調整
掃描時基線比例按深度定位法將時間軸(最大量程)調整為 60mm。
3. 掃查靈敏度調整采用校準試塊調整掃查靈敏度,規定如下:
a) 瓷套壁厚不大於 30mm,將校準試塊上深度為 20mm 的Φ1mm 橫通孔反射波高調到 80% 屏高,增益2dB;
b) 瓷套壁厚大於 30mm,將校準試塊上深度為 40mm 的Φ1mm 橫通孔反射波高調到 80% 屏高,增益 4dB。
4. 缺陷的檢測
1) 掃查方式
a) 將探頭置於支柱瓷絕緣子或瓷套的傘裙與法蘭間,探頭前沿對準法蘭側,並保證探頭與檢測麵 的良好耦合。掃查速度不應超過 150mm/s(當采用自動報警裝置掃查時不受此限製),掃查覆蓋率應大 於探頭直徑的 10%。
b) 采用爬波法檢測時,探頭應盡可能向法蘭側前移,保持穩定接觸,作周向 360°掃查。
c) 采用縱波斜探頭或雙晶橫波探頭檢測時,在移動範圍許可的情況下,探頭可作前後移動,進行 周向 360°掃查。
d) 對缺陷進行定量(最大反射波幅值及指示長度)和位置的測定
2) 缺陷的定量測定
缺陷的定量測定方法如下:
a) 找到缺陷反射波的最大波高,根據 圖 1 調整掃查靈敏度的方法,與相近聲程Φ1mm 橫通孔進 行當量比較,判定為不小於Φ1mm 橫通孔當量或不大於Φ1mm 橫通孔當量,記錄為Φ1±( )dB;
b) 移動探頭,如缺陷波連續存在,采用半波高度法測定缺陷的指示長度;
c) 缺陷指示長度的修正
采用小角度縱波斜入射法檢測時,應對用半波高度法(6dB法)測出的缺陷指示長度進行修正,缺 陷指示長度值按下式計算:
L=(1-2H/D)L0
式中:L0—用半波高度法(6dB 法)測量時探頭位置之間的距離,mm;
’H—缺陷的深度,mm; D—絕緣子直徑,mm。
3) 根據探頭在探測麵上的位置和最高反射波在示波屏上的水平位置確定缺陷的周向位置和深度,並做好記錄。
5. 反射回波的識別
D.1 小角度縱波法檢測支柱瓷絕緣子反射回波分析
D.1.1 當示波屏顯示僅有孤立底波,無雜波,波形清晰,應判定無缺陷,如圖D.1 。
D.1.2 當支柱瓷絕緣子內部晶粒粗大時,探頭掃查時會出現草狀反射波(在探傷靈敏度下一般波高小 於30%屏高),探頭稍作移動,反射波會立即下降或消失,此時應判定為晶粒反射波。
D.1.3 當支柱瓷絕緣子內部存在雜質、氣孔及裂紋等缺陷,底波前會出現點狀或叢狀反射波,底波可 能會降低或消失,此時應判定為缺陷波,如圖D.2所示。
D.1.4 當在支柱瓷絕緣子探測麵的對應側表麵存在裂紋時,底波前會出現裂紋波,隨著裂紋深度的增 大,裂紋波與底波的間距增大,且底波會降低,如圖D.3所示。
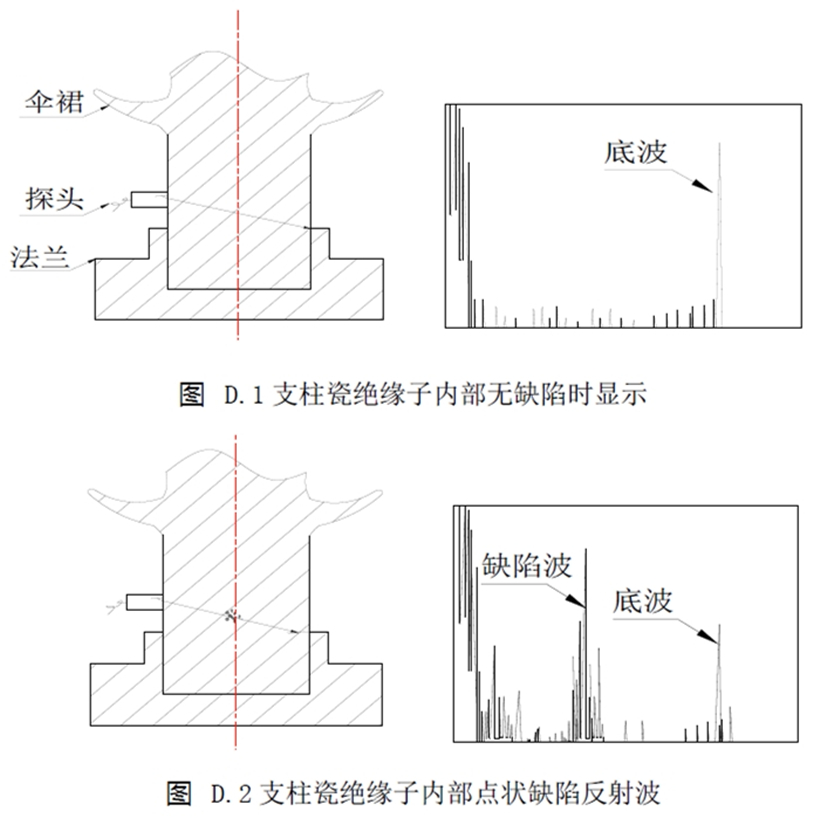

D.2 爬波法檢測支柱瓷絕緣子及瓷套反射回波分析
D.2.1 當支柱瓷絕緣子或瓷套的表麵或近表麵無缺陷時,示波屏顯示基本無波,如D.4所示。
D.2.2 當支柱瓷絕緣子或瓷套被檢部位的表麵或近表麵存在折痕、壓痕、氣孔、雜質、波紋或裂紋時,會出現點狀或叢狀反射波,此時,應與繪製的距離—波幅曲線進行比較,波高超出曲線的應判定為不合 格缺陷;反射波幅等於或低於距離—波幅曲線高度,且指示長度不小於10mm,判定為不合格缺陷。如圖 D.5、圖D.6所示。
D.2.3 當支柱瓷絕緣子或瓷套外壁存在裂紋時,裂紋波前基本無雜波,移動探頭,距離裂紋越近,反 射波高越強。
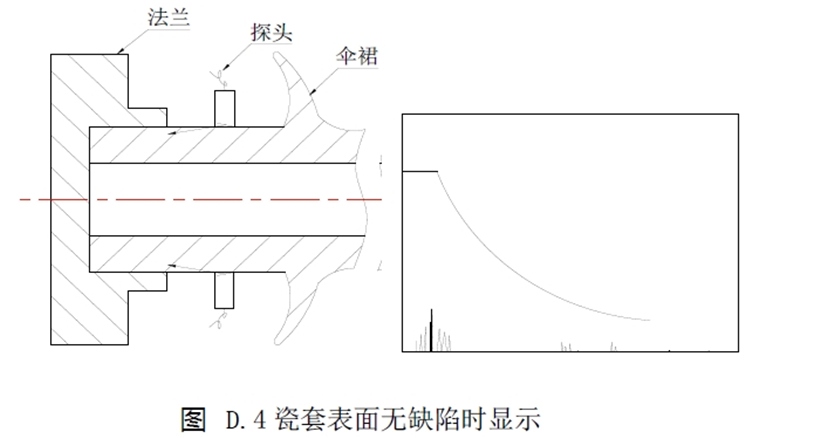
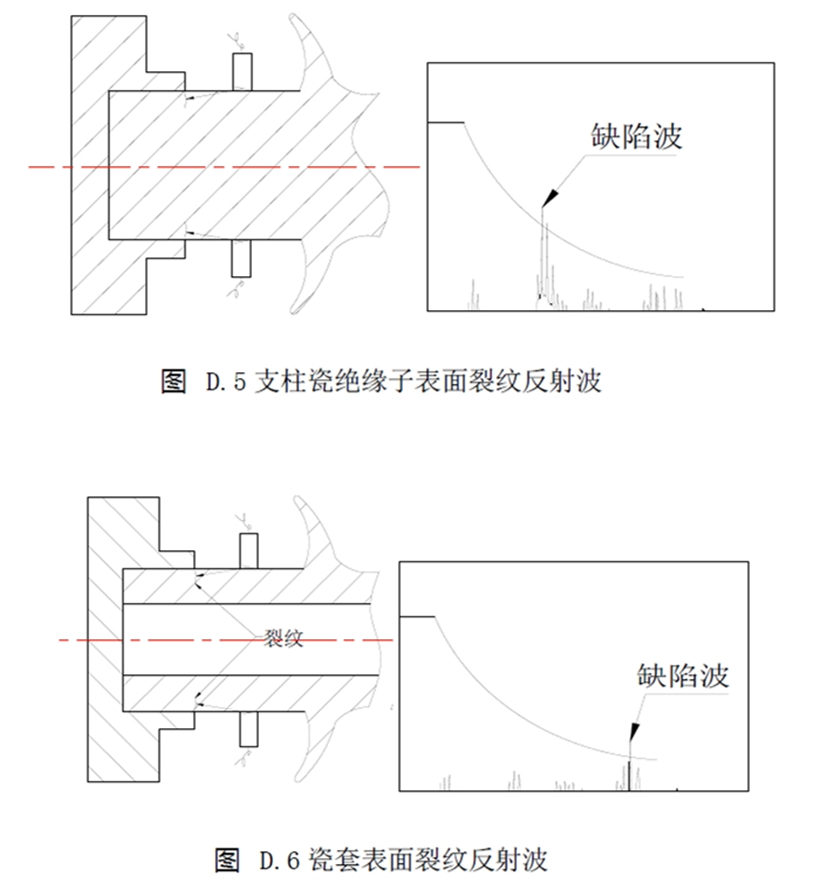
D.3 雙晶橫波法檢測瓷套反射回波分析
D.3.1 當直射波範圍內未出現反射波,應判定內部和內壁無缺陷,如圖D.7所示。
D.3.2 當瓷套內部存在雜質、氣孔及裂紋等缺陷,底波位置前會出現點狀或叢狀反射波,應判定內部 有缺陷,如圖D.8所示。
D.3.3 當瓷套內壁存在雜質、氣孔及裂紋等缺陷,底波位置前會出現點狀或叢狀反射波,如圖D.9所示。
